28th作者:John Lindsay博士
Ga FIB铣削对分析的影响
FIB-SEM是一种相对常见的样品制备方法,适用于SEM和TEM分析。在用离子束制备样品时,如果要制备出好的样品,需要考虑多个方面。一个好的样本通常被认为是一个图像良好的样本(没有明显的样品制备工件),但这并不是分析时的唯一考虑因素。在这里,我将给出一些FIB准备如何影响分析的例子,以及一些如何减轻影响的建议。
垂落
FIB制备样品时最明显的效果是遮蔽。当样品中含有不同的材料,且铣削速率不同时,就会发生遮盖现象。它被认为是不可取的,因为它会产生成像伪影,并且在制备TEM样品时,限制了可存档的样品厚度。当涉及到分析分析时,与遮蔽有关的地形可能导致阴影和低能量峰的吸收。
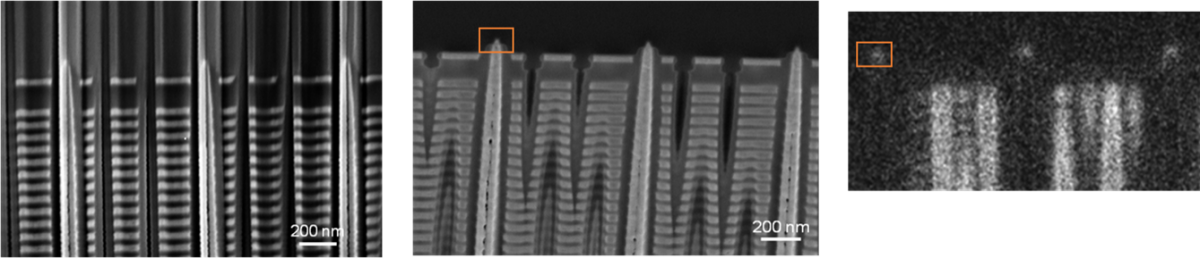
图1左图:常规铣削加帘制样;中心:样品的背面稀释,以避免窗帘;右图:背面稀释样品的氮能谱图。
在上面的例子中,我们有相同的样本,在感兴趣的区域有和没有窗帘(详细说明如何实现这一点在这里找到).用Ultim Extreme对样品进行EDS测绘,结果显示钨通孔尖端的氮浓度(如橙色框所示)。对被遮盖的样品进行同样的分析,结果没有观察到这种氮浓度。常用的缓解遮蔽的方法是改变样品的取向,沉积保护层,以及用降低的离子束电流进行铣削。
污染
离子研磨对能谱分析的另一个潜在影响是污染。当用于研磨的离子注入或研磨后的材料重新沉积在样品上时,就会发生污染。再沉积通常在(但不限于)横截面的底部观察到。再沉积材料组合物是研磨材料(来自样品或类似抬升网格的支撑结构)和来自离子束的离子的组合。下面的例子(图2)显示了固态锂离子电池的镓污染(不含镓)。在横断面EDS图中,在横断面的底部观察到大量的镓,但重要的是,在被分析的颗粒中,顶部没有镓。

图2锂离子电池截面。在横截面底部观察到再沉积。这可以从镓(不存在于材料中)的EDS图中看到。
通过避免过度铣削(避免将材料铣削到表面以下)和在制备的最后步骤中使用较温和的条件,可以最大限度地减少再沉积。另一个值得注意的问题;如果你正在观察含有铜的样品,应该避免使用铜提升网格。
结构变化
离子铣削不仅会影响样品的化学性质,还会影响晶体结构。这方面一个著名的例子是硅的非晶化。图3中的EBSD信号图像取自同一硅晶体,但其中一张是在30kev和500pA抛光后拍摄的(没有菊地图案产生),另一张是在5keV和500pA抛光后拍摄的(清楚菊地图案)。没有图案并不是因为探测器的原因,而是因为EBSD是一种表面敏感技术,表面已经非晶态化,这意味着没有图案生成。

图3单晶硅的图案,左为30keV 500pA离子抛光后的图案,右为5keV 500pA离子抛光后的图案。两者都是从相同的地图中提取的,使用20 keV和1 nA电子束获得。
相变
除了破坏晶体结构,离子束的相互作用还可以改变相;一个常见的例子是奥氏体不锈钢(SS)。下图(图4)显示了奥氏体SS的EBSD图,其中3个区域暴露在不同的离子束剂量下。通过对垂直于离子束的区域进行30秒、20秒和10秒的成像(使用30keV、1 nA光束和300 nS驻留时间),可以获得不同的剂量。在高剂量区域发生了奥氏体向铁素体的相变,而在低剂量区域则没有发生相变。
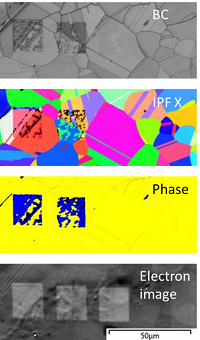
图4带对比图、取向图、相图(奥氏体黄、铁素体蓝)及对应电子图像。3个区域暴露于30 keV, 1 nA。离子束暴露时间从左到右减少。
当涉及到避免晶体损伤时,离子束加速电压是关键,低电压不太可能产生损伤。尽管如上面的SS例子所示,剂量也是一个重要因素。
虽然我已经展示了离子束如何破坏样品的例子;这些影响是罕见的,通常可以通过小心来避免/减轻。当使用新材料或离子源时(所示的例子都来自Ga FIB),了解它们如何相互作用是很重要的。使用EBSD而且EDS除了对生产的样品进行表征外,还可以对相互作用进行量化。








